BGA封装类型特点
随着BGA芯片使用越来越广,那么BGA封装类型也是越来越多,越来越完善,接下来就由崴泰科技BGA返修台厂家小编给大家介绍一下BGA封装的类型特点都有哪些。
首先我们了解一下BGA 封装的类型、结构
BGA的封装类型多种多样,其外形结构为方形或矩形。根据其焊料球的排布方式可分为周边型、交错型和全阵列型BGA,根据其基板的不同,主要分为三类:PBGA(PlasticballZddarray 塑料焊球阵列)、CBGA(ceramicballSddarray 陶瓷焊球阵列)、TBGA(tape ball grid array 载带型焊球阵列)。

1. PBGA(塑料焊球阵列)封装
PBGA 封装,它采用BT 树脂/玻璃层压板作为基板,以塑料(环氧模塑混合物)作为密封材料,焊球为共晶焊料63Sn37Pb 或准共晶焊料62Sn36Pb2Ag(目前已有部分制造商使用无铅焊料),焊球和封装体的连接不需要另外使用焊料。PBGA 封装的结构示意图如图4。有一些PBGA 封装为腔体结构,分为腔体朝上和腔体朝下两种。这种带腔体的PBGA 是为了增强其散热性能,称之为热增强型BGA,简称EBGA,有的也称之为CPBGA(腔体塑料焊球阵列),其结构示意图如图5。PBGA 封装的优点如下: 1)与PCB 板(印刷线路板-通常为FR-4板)的热匹配性好。PBGA 结构中的BT 树脂/玻璃层压板的热膨胀系数(CTE)约为14ppm/℃,PCB 板的约为17ppm/cC,两种材料的CTE 比较接近,因而热匹配性好。
2.在回流焊
过程中可利用焊球的自对准作用,即熔融焊球的表面张力来达到焊球与焊盘的对准要求。
3.成本低。
4.电性能良好。 PBGA 封装的缺点是:对湿气敏感,不适用于有气密性要求和可靠性要求高的器件的封装。
5.CBGA(陶瓷焊球阵列)封装
在BGA 封装系列中,CBGA 的历史最长。它的基板是多层陶瓷,金属盖板用密封焊料焊接在基板上,用以保护芯片、引线及焊盘。焊球材料为高温共晶焊料10Sn90Pb,焊球和封装体的连接需使用低温共晶焊料63Sn37Pb。其结构示意图如图6,封装体尺寸为10-35mm,标准的焊球节距为1.5mm、1.27mm、1.0mm。

CBGA(陶瓷焊球阵列)封装的优点如下:
1.气密性好,抗湿气性能高,因而封装组件的长期可靠性高。 2)与PBGA 器件相比,电绝缘特性更好。 3)与PBGA 器件相比,封装密度更高。 4)散热性能优于PBGA 结构。 CBGA封装的缺点是: 1)由于陶瓷基板和PCB 板的热膨胀系数(CTE)相差较大(A1203 陶瓷基板的CTE 约为7ppm/cC,PCB 板的CTE 约为17ppm/笔),因此热匹配性差,焊点疲劳是其主要的失效形式。 2)与PBGA 器件相比,封装成本高。 3)在封装体边缘的焊球对准难度增加。
2.CCGA(ceramic column Sddarray)陶瓷柱栅阵列
CCGA 是CBGA 的改进型。如图7 所示。二者的区别在于:CCGA 采用直径为0.5mm、高度为1.25mm~2.2mm 的焊料柱替代CBGA 中的0.87mm 直径的焊料球,以提高其焊点的抗疲劳能力。因此柱状结构更能缓解由热失配引起的陶瓷载体和PCB 板之间的剪切应力。
3. TBGA(载带型焊球阵列)
TBGA是一种有腔体结构,TBGA 封装的芯片与基板互连方式有两种:倒装焊键合和引线键合。倒装焊键合结构示意图如图8(a);芯片倒装键合在多层布线柔性载带上;用作电路I/O 端的周边阵列焊料球安装在柔性载带下面;它的厚密封盖板又是散热器(热沉),同时还起到加固封装体的作用,使柔性基片下面的焊料球具有较好的共面性。腔体朝下的引线键合TBGA 结构示意图如图8(b);芯片粘结在芯腔的铜热沉上;芯片焊盘与多层布线柔性载带基片焊盘用键合引线实现互连;用密封剂将电路芯片、引线、柔性载带焊盘包封(灌封或涂敷)起来。 TBGA 的优点如下: 1)封装体的柔性载带和PCB 板的热匹配性能较 2)在回流焊过程中可利用焊球的自对准作用, 印焊球的表面张力来达到焊球与焊盘的对准要求。
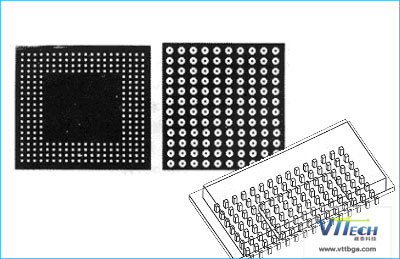
3)是最经济的BGA 封装。
4)散热性能优于PBGA 结构。
TBGA 的缺点如下:
1.对湿气敏感。
2.不同材料的多级组合对可靠性产生不利的影响。
3.其它的BGA 封装类型
MCM-PBGA(Multiplechipmodule-PBGA),多芯片模块PBGA。LBGA,微BGA,它是一种芯片尺寸封装。芯片面朝下,采用TAB 键合实现芯片与封装基片焊盘互连的,LBGA 的结构示意图如图10。它的封装体尺寸仅略大于芯片(芯片+0.5mm)。
gBGA 有3 种焊球节距:0.65mm、0.75mm 和0.8mm。TAB 引线键合和弹性的芯片粘接是txBGA 的特征。与其它的芯片尺寸封装相比, 它具有更高的可靠性。SBGA(Stackedballgridarray),叠层BGA,它的结构示意图如图11 所示。 etBGA,最薄的BGA 结构,封装体高度为0.5mm,接近于芯片尺寸。芯片面朝下,芯片-基板互连采用引线键合方式的et-BGA 的结构示意图如图12 。 CTBGA 、CVBGA(ThinandVeryThinChipArrayBGA),薄型、超薄型BGA。该种BGA 使用的基板是薄的核心层压板,包封采用模塑结构,封装体高度为1.2mm。 几种常规BGA 封装类型的比较如表1 所示。 4BGA 的封装工艺流程 基板或中间层是BGA 封装中非常重要的部分,除了用于互连布线以外,还可用于阻抗控制及用于电感/电阻/电容的集成。因此要求基板材料具有高的玻璃转化温度rS(约为175~230℃)、高的尺寸稳定性和低的吸潮性,具有较好的电气性能和高可靠性。金属薄膜、绝缘层和基板介质间还要具有较高的粘附性能
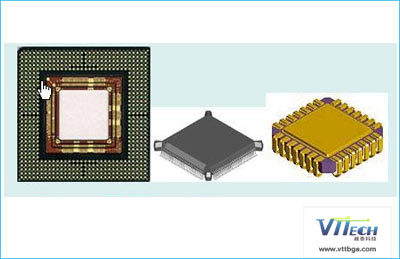
在了解了BGA封装类型后,接下来我们了解一下BGA封装的特点都有哪些:
BGA(Ball Grid Array)封装,即焊球阵列封装,它是在封装体基板的底部制作阵列焊球作为电路的I/O 端与印刷线路板(PCB)互接。采用该项技术封装的器件是一种表面贴装型器件。与传统的脚形贴装器件(LeadedDe~ce 如QFP、PLCC 等)相比,BGA 封装器件具有如下特点。 1)I/O 数较多。
BGA 封装器件的I/O 数主要由封装体的尺寸和焊球节距决定。由于BGA 封装的焊料球是以阵列形式排布在封装基片下面,因而可极大地提高器件的I/O数,缩小封装体尺寸,节省组装的占位空间。通常,在引线数相同的情况下,封装体尺寸可减小30%以上。例如:CBGA-49、BGA-320(节距1.27mm)分别与PLCC-44(节距为1.27mm)和MOFP-304(节距为0.8mm)相比,封装体尺寸分别缩小了84%和47%。提高了贴装成品率,潜在地降低了成本。
传统的QFP、PLCC 器件的引线脚均匀地分布在封装体的四周,其引线脚的节距为1.27mm、1.0mm、0.8mm、0.65mm、0.5mm。当I/O 数越来越多时,其节距就必须越来越小。而当节距<0.4mm 时,SMT 设备的精度就难以满足要求。加之引线脚极易变形,从而导致贴装失效率增加。其BGA 器件的焊料球是以阵列形式分布在基板的底部的,可排布较多的I/O 数,其标准的焊球节距为1.5mm、1.27mm、1.0mm,细节距BGA(印BGA,也称为CSP-BGA,当焊料球的节距<1.0mm时,可将其归为CSP 封装)的节距为0.8mm、0.65mm、0.5mm,与现有的SMT 工艺设备兼容,其贴装失效率<10ppm。 3)BGA 的阵列焊球与基板的接触面大、短,有利于散热。
BGA阵列焊球的引脚很短,缩短了信号的传输路径,减小了引线电感、电阻,因而可改善电路的性能。 5)明显地改善了I/O 端的共面性,极大地减小了组装过程中因共面性差而引起的损耗。 6)BGA 适用于MCM 封装,能够实现MCM 的高密度、高性能。 7)BGA 和~BGA 都比细节距的脚形封装的IC 牢固可靠。
本文《BGA封装类型特点》由崴泰科技BGA返修台厂家小编撰写如需转载,请注明出处,谢谢!

