晶圆植球机,植球动作流程,VTTECH技术解决方案
一、晶圆植球技术简介
晶圆级植球工艺是将微小尺寸的焊球(百微米级)直接放置到刻好电路的晶圆上,经过回流焊炉固化后再进行晶圆的切割和芯片的分选,分选出的芯片通过倒封装(Flip Chip)工艺贴合到基板上。采用晶圆级植球工艺封装的芯片避免了额外的封装并提供了比如高运行频率、低寄生效应和高I/O密度等优点。
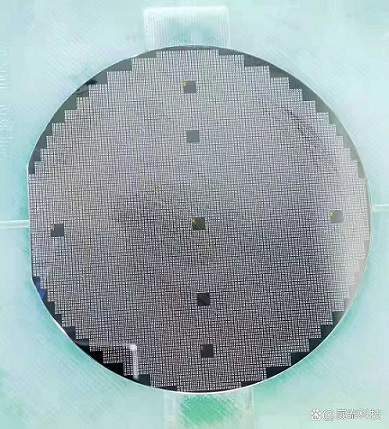
微球植球机是3D芯片晶圆级封装工艺中的必备核心设备之一。近几年晶圆级植球技术的快速发展,其原因有两个。一是随着CSP类封装型式IC消费量的增加,IC制造的成本压力进一步加大。传统的化学电镀BUMPING工艺显示出造价贵、制造周期长、环境污染、工艺复杂和参数不稳定等缺点,因此业界一直在寻找替代解决方案,晶圆级植球技术的突破恰好满足了这一需求。二是多层堆叠技术(MCM)的发展要求晶圆与晶圆间具有高精度的多引脚的100微米级的互联,只有晶圆级植球技术可以稳定地实现此愿望。随着网络通信领域技术的迅猛发展,数字电视,信息家电和3G手机等产品将大量需要高端IC电路产品,进而对高引脚数的MCM (MCP), BGA, CSP, 3D, SiP, PiP, PoP等中高端产品的需求十分旺盛。WLP晶圆级封装芯片键合自动化系统是高端IC封装设备的关键设备之一,在越来越引起广泛重视的TSV高端IC封装中将大显身手。注意:此类应用引脚尺寸介于100微米至300微米之间,小于100微米的引脚基本不采用此方法。
晶圆级植球工艺在国内刚刚开始应用,全球2012年销售预期将达到15条线以上并将保持年均20%以上的增长,具有良好的市场前景。目前市场上存在的晶圆级植球装备都是国外产品,价格高昂且服务不足,掌握核心技术的国产设备将具有很强竞争力。
二、晶圆植球机简介
晶圆级植球动作流程如下:
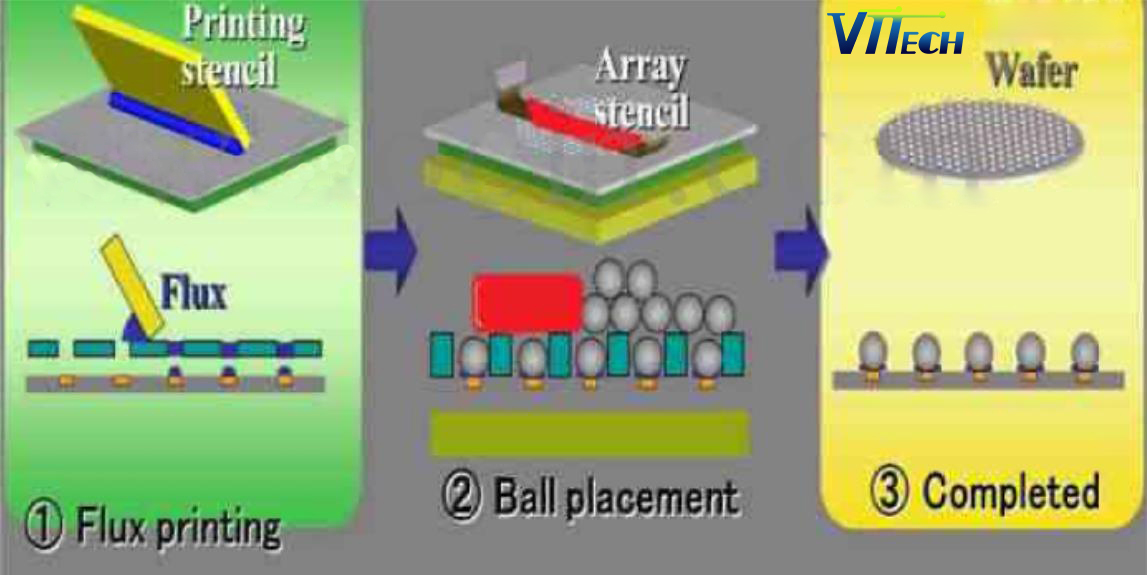
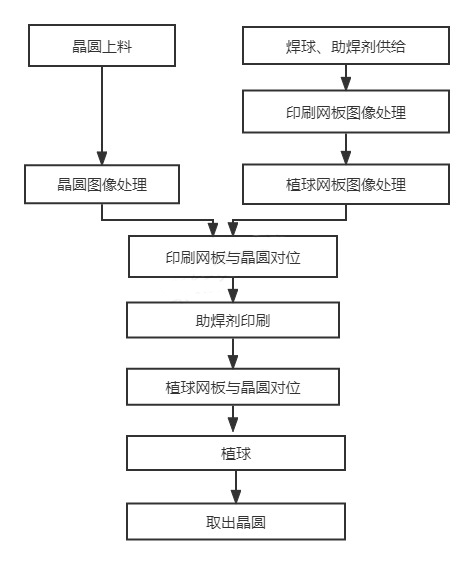
影响晶圆级植球效果的主要因素有:传动机构的精度;图像定位系统的精度和算法;网板的厚度、孔径等参数设定;对网板的压力控制和弹性变形的控制和补偿;植球机构和供球系统的设计。
三.崴泰VTTECH晶圆植球机技术解决方案
1.全自动解决方案
主要技术指标如下:

特征:
■拥有专利的植球方式,实现了稳定植球。
■残球除去过程与植球过程同时进行,提高了生产效率。
■实现治具的低成本、易更换。
■采用精简的机构,配合中文操作界面,实现了维护的简易化。

2.半自动型解决方案
主要技术指标如下:


崴泰VTTECH晶圆植球解决方案优势:
1.超精密丝网印刷技术
晶圆级植球工艺中,需要利用丝网印刷技术把助焊剂印刷到晶圆上。丝网印刷用网板是微米级的薄板,晶圆和刮刀与网板的接触都会造成印刷网板的弹性变形。对这种变形的精确控制以及合适的工艺参数最终实现刘精确的助焊剂印刷量控制并实现微米级的印刷精度。
2.自动网板清洁系统
全自动的清洁纸传送和清洁液供给系统,实现对印刷网板和植球网板的自动清洗,以保证最终的植球质量。
3.晶圆级微球搭载技术
通过研究球径、晶圆尺寸和压力的关系曲线,研究测量反馈系统的误差校正算法,设计实现Z轴压力的精确控制以实现良好的植球效果。实现了焊球的自动供球、回收和循环系统。
4.精密定位系统和算法
晶圆级植球机需要实现30微米的助焊剂印刷精度和植球精度,这就需要高重复定位精度的伺服控制系统,同时结合图像处理的结果,对系统误差和随机误差进行测量和校正。
5.人机界面友好,便于操作。
以上就是关于《晶圆植球机,植球动作流程,VTTECH技术解决方案》的技术要点,希望能给到大家一些帮助。如果你正在找晶圆植球机,请联系崴泰科技了解更多相关内容。

