BGA返修焊接时出现连桥和焊料成团的原因
BGA返修焊接对于现在BGA返修行业来说是越来越重要了,因为芯片的成本不断在上升,各EMS大厂都需要为如何返修焊接BGA芯片做出思考,因为如果BGA返修台选择不对,在返修过程中很容易造成连桥和焊料成团的情况发现,那么是什么引起这两种情况的发生呢,接下来由崴泰科技BGA返修台小编为大家介绍一下:
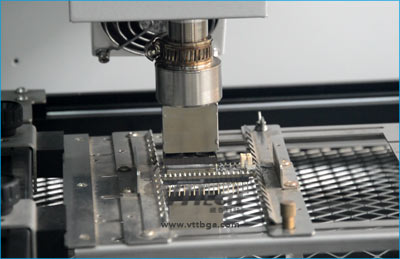
一. BGA焊接出现连桥
间距为0.060英寸(1.50mm)或0.050英寸(1.0mm)的细间距BGA组件在相邻的互连位置之间不易形成连桥。除间距尺寸外,还有两个因素影响连桥问题。
1.与焊盘尺寸相关的过多的焊料量
由于两个相邻位置间熔融焊料的相互亲和,当焊料过多时,就可能出现连桥。每种BGA的特性各不相同,这取决于所用的合金成份、载体焊料球的熔融温度、与载体焊料球相关的焊盘设计和载体的重量。例如,在其他条件相等的情况下,含高温焊料球载体(在板组装期间不熔化)不易形成连桥。
2.焊膏坍塌
使用焊膏作为互连材料时,印刷和再流焊期间焊膏坍塌现象对连桥起重要作用。所需的抗坍塌特性大大影响焊剂/赋形剂系统的热动态特性。因此,在既能均匀地润湿焊粉表面又能给高粘合力的化学系统结合料中,设计为焊粉提供充分表面张力的焊剂/赋形剂系统是非常重要的。
二.BGA焊接出现焊料成团
再流焊后,板上疏松的焊料团如不去除,工作时可导致电气短路,也可使焊缝得不到足够的焊料。形成焊料团的原因有以下几种情况:
1.对于焊粉、基片或再流焊预置没有有效地熔融,形成未凝聚的离散粒子。
2.焊料熔融前(预加热或预干燥)焊膏加热不一致,造成焊剂活性降级。
3.由于加热太快造成焊膏飞溅,形成离散的焊粉或侵入到主焊区外面。
4.焊膏被湿气或其它高”能量”化学物质污染,从而加速溅射。
5.加热期间,含超细焊粉的焊膏被有机物工具从主焊区带走时,在焊盘周围形成晕圈。
6.焊膏和焊接防护罩之间的相互作用。
本文《BGA返修焊接时出现连桥和焊料成团的原因》由崴泰科技BGA返修台厂家http://www.vttbga.com/撰写,如需转载,请注明出处,谢谢!

