散热凸台BGA芯片的焊接返修
散热凸台BGA芯片是一种新形的BGA封装形式,那么他是如何进行焊接返修的呢,由于底部散热凸台的支撑作用,在焊接过程中,热凸台BGA芯片相对于一般的PBGA不能自由的伸缩,冷却时会产生较大的应力,位于边缘处的焊点很容易拉裂,如下图。
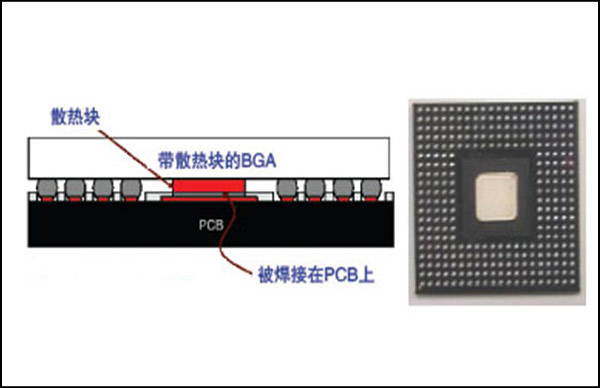
BGA的焊接与一般器件的焊接有所不同,存在两个特殊的热过程:两次塌落与热变形。
BGA焊接时,先是焊膏熔化并塌落,然后焊球熔化并 二次塌落。许多的试验证明,只有发生二次塌落,BGA才能实现自动校准和焊膏焊球成分的融合,这就需要合适的温度与焊接时间。
热变形对BGA来说,焊接加热时总是BGA表面先被加热,接下来是封装体被加热,最后才是焊点被加热并最终熔化, 冷却时则相反。这样的加热过程必然导致升温时BGA的顶部比底部温度高,因而向上弓曲,冷却时,则是顶部比底 部的温度低,因而四角上翘,如图2所示。
也就是BGA进行 回流焊接时存在一个热胀冷缩的变形过程。由于BGA器件 的I/O端是以焊球形式存在并布局在封装体的底部,在焊接 过程中,封装体的形变必然影响到焊点的形成过程,特别是BGA的周边焊点。
这两次的变形都发生在温度变化比较快的阶段,不管上弓还是四角上翘,他们都发生在焊接过程中。对一般的 PBGA而言,焊接完成后BGA会基本恢复到焊接前的状态,
也就是封装体仍然会基本平整。但对Slug-BGA而言,由于 其芯部存在散热凸台,冷却时芯部不能自由收缩,焊接完 成后热变形不能完全恢复;焊点,特别是靠近BGA四边的 焊点就会存在一些应力。如果焊接时,BGA封装体还没有 完全达到热平衡状态就转入冷却阶段,这时的应力就会很大,在冷却时有可能使焊点发生断裂。
散热凸台BGA芯片焊接时容易发生两个问题:
一、是焊接温度不够,达不到二次塌落的温度。这样焊点在凝固时焊球仍处于半固半液的“糊状”形态,焊点 很容易发生断裂。
二、是焊接时间不够,准确地说是散热凸台BGA芯片达到峰值温 度后的停留时间不够,散热凸台BGA芯片封装的变形还没有恢复, 仍处于芯部上弓的状态。如果这时进入冷却阶段,在四角 上翘拉力和芯部散热凸台向下的双重作用下,焊点很容易拉断。即使没有拉断,焊点由于受到很大的应力,对长期 可靠性是不利的。
为一个散热凸台BGA芯片焊接后所做的一个 切片图,我们可以看到越靠边缘处的焊点高度越小,越靠 散热凸台的焊点高度越大,在系列试验中的最大高度差达 到焊点平均高度的三分之一。
所以为了消除散热凸台BGA芯片存在的焊点断裂现象,必须注意两点:
一、是焊接温度必须足够,达到二次塌落的最低温度要 求;二是焊接的时间必须足够,准确地说,就是比峰值温度小5℃以上的回流焊接时间必须足够。
我们在散热凸台BGA芯片焊接返修时需要区分是否含铅,有铅和无铅的焊接温度曲线是不同的,必需要搞情楚才能够保证返修良率。
本文由崴泰科技BGA返修台厂家http://www.vttbga.com撰写,如需转载请注明出处,谢谢合作!

